-
メールsales@efpcb.com
-
会社所在地Shenzhen, Guangdong, China
-
+86-755-23724206電話してください
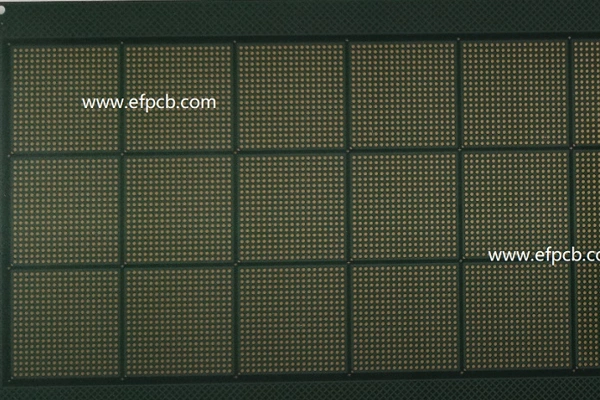
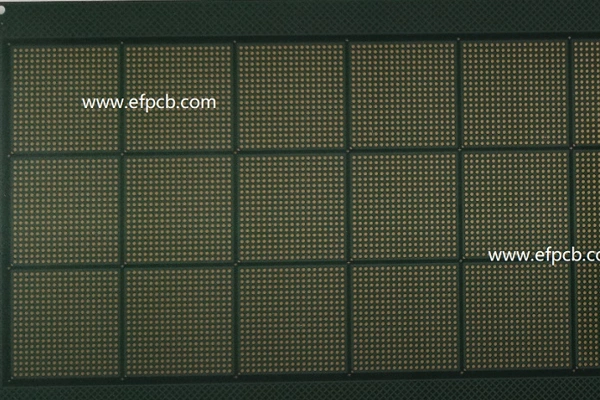

部品番号 : E0236060119B
基板の厚さ: 0.24+/-0.03mm
層数:2層
コア材料: HL832NXA
溶接マスク: AUS308
最小の痕跡: 120 um
最小スペース(ギャップ): 25 um
最小穴: 0.075 mm
終わった表面: ENEPIG
ユニットサイズ: 18*18mm
HL832NXAデータシート:
これらはPWB使用のためのハロゲンフリー材料です。ハロゲンフリー材料は,ハロゲン,アンチモン,リン化合物を使用せずにUL94V-0の燃焼性評価を達成します.阻燃剤として無機填料を置き換えることは,小穴CO2レーザー掘削の特性を改善し,CTEを低下させることの追加的な利点があります.
| 銅クラッドラミネート | プレプレグ | CCLの厚さ | プレプレグ厚さ |
|---|---|---|---|
| CCL-HL832NX型 タイプAシリーズ | GHPL-830NX タイプAシリーズ | 0.03, 0.04, 0.05, 0.06, 0.1, 0.15, 0.2, 0.25, 0.3, 0.35, 0.4, 0.45, 0.5, 0.6, 0.7, 0.8 | 0.02 ~ 0.1 |
CCL-HL832NXタイプA / GHPL-830NXタイプAは,ICプラスチックパッケージのためのハロゲンフリーBT材料です.
これらは良い耐熱性、高い硬度、低いCTEのために良良い良良い耐熱性、高い硬度、低いCTEのためにこれこれらはこれらは無これこれらはこれこれらは良い耐耐熱性、高い耐熱性、高い
これらは,ICプラスチックパッケージ用のハロゲンフリー材料の事実上の標準として様々なアプリケーションで使用されています.
CSP、BGA、フリップチップパッケージ、SiP、モジュール、等
ICキャリア基板BGAについて
金属接触パッケージは、以前の針のようなピン技術に置き換える
BGAの全名はBall Grid Arrayで、文字通りグリッド配列パッケージングを意味します。インテルプロセッサ以前のパッケージング技術ソケット478に対応し、ソケットTとも呼ばれています。主に以前のピンピンを置き換えるために金属接触パッケージを使用するため、「飛躍的な技術革命」です。BGA775は、名前から示すように、775つのコンタクトを持っています。
ピンがコンタクトに変更されるため,BGA775インターフェースのプロセッサもインストール方法で他の製品と異なります.ピンで固定することはできませんが,CPUがソケットによって露出された弾性のあるウイスカーを正しく押すように固定するためにマウントバックルが必要です.その原理はBGAパッケージと同じですが、BGAはいつでもバックルを解放してチップを置き換えることができます。