-
우리에게 메일sales@efpcb.com
-
회사 위치Shenzhen, Guangdong, China
-
+86-755-23724206저희에게 전화하세요


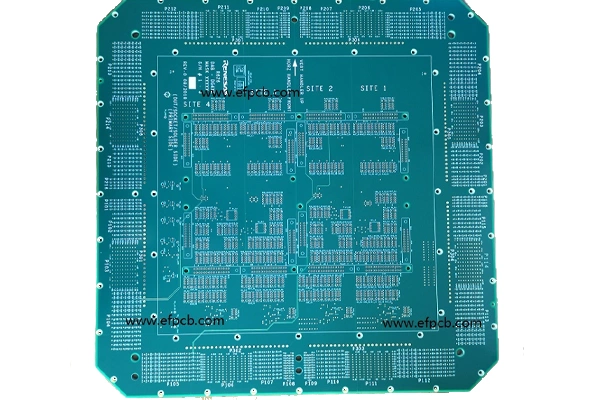
부품 번호: E1615060170A
층 수: 16 층
자료: FR4, 4.8mm의 모든 층을 위한 1 OZ
최소 트랙: 6 mil
최소 공간 (간격): 5 mil
최소 구멍: 0.50mm
끝난 표면: 전체 보드 단단한 금, Au > 40 microinches
패널 크기: 598*578mm/1up
백플레인 그 자체는 특별한 종류의PCB주로 신호, 전원 공급, 관리 인터페이스 등을 포함하여 시스템의 다양한 유형의 하위 카드에 대한 상호 연결 채널을 제공하는구조는 또한 하위 카드를 지원하는 역할을 합니다.
고속 백플레인과 일반 백플레인의 차이점은 고속 백플레인의 신호 상호 연결 속도가 높고,PCB사용되는 재료와 백플레인 연결관은 고속 관련입니다.아래 그림은 전통적인 고속 백플레인 상호 연결 시스템을 보여줍니다. 이 시스템은 주로 백플레인, 하위 카드 및 연결관으로 구성되어 있습니다.
1. 하위 카드 및 백플레인의 박판으로 만들어진 구조 및 라우팅
2. 백플레인 연결관 성능
3. AC 용량 및 통해
4. 칩 포장
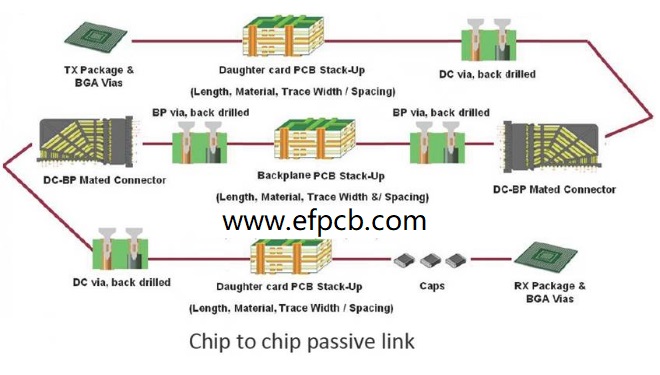
현재 IEEE와 OIF는 이전 기사에서 소개한 백플레인 상호 연결 구조의 표준 정의입니다.IEEE의 백플레인 응용 프로그램의 표준은 40gbase-kr4와 같은 Kr입니다.OIF의 백플레인 응용 프로그램의 표준은 cei-25g-lr와 같은 LR입니다. 이 두 사양은 백플레인 상호 연결 시스템에 대한 더 자세한 주파수 도메인 참조 지수 요구 사항을 가지고 있습니다.
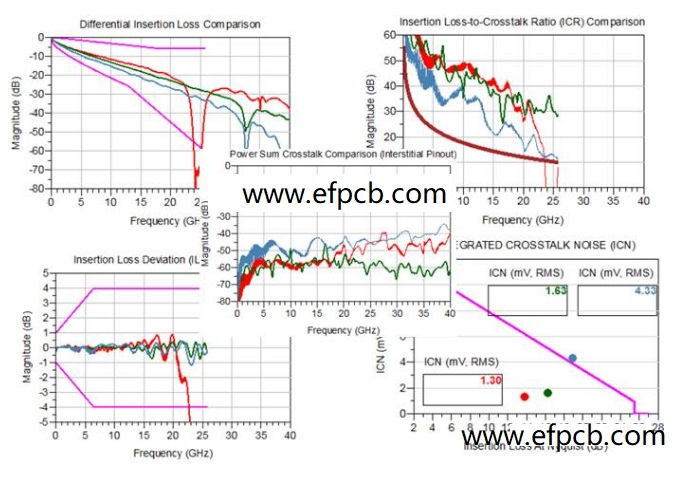
전통적인 것 외에도 백플레인 시스템 또한 정각형 백플레인 시스템 구조가 있습니다.정각형 백플레인 구조에서는 서비스 카드와 양쪽의 스위치 카드가 수직 각도로 백플레인에 직접 삽입됩니다.백플레인은 여러 서비스 카드와 스위치 카드를 오직 정각형 커백터백터를 통해 연결할 수 있습니다.중간 백플레인의 라우팅 연결이 중중단되어 있으므로 전체 라우팅 길이가 짧고 감소가 작게 될 수 있습니다.
그러나 정각형 백플레인 시스템의 양쪽에 있는 보드의 수직 각도로 인해 공기 배관을 설계하는 것은 쉽지 않으므로 가장 큰 문제는 전체 기계의 나쁜 환기와 열 분산입니다.또한 백플레인의 통로길이는 일반적으로 길고 임피던스 불연속성은 심각하므로 고속 성능 크로스오버가 발생합니다.
위의 문제를 해결하기 위해 업계는 직접 정각형 건축 기술을 제안했습니다. 즉, 중앙 백플레인이 없으며 비즈니스 카드와 교환 카드는 커이열열 열 분산 효과가 더 나아집니다.동시에, 더 이상 구멍을 통해 백플레인이 없으며, 신호 무결성의 성능을 향상시킵니다.
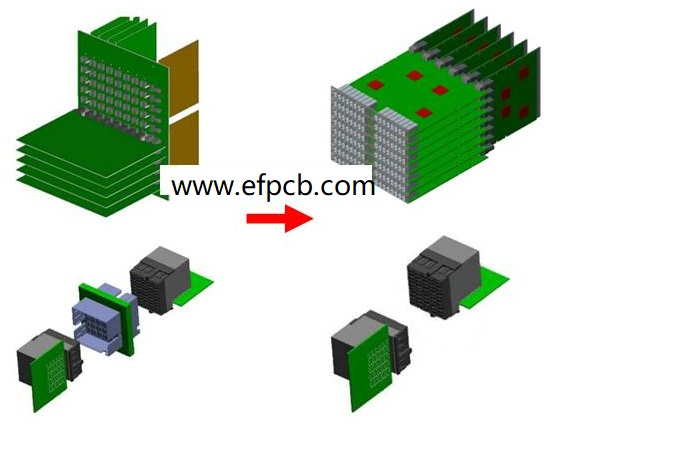
IEEE와 OIF 모두 백플레인 상호 연결 애플리케이션의 전기 성능만 정의하며 표준 백플레인 커표표표 표준, 백플레인 크기, 시스템 관리 등과 같은 특정 백플레인 아키텍처 표준을 정의하지 않습니다.
ATCA는 고속 백플레인 아키텍처의 정의를 가진 표준 중 하나입니다.ATCA (Advanced Telecom Computing Architecture)는 PICMG에 의해 개발되었으며 주로 통신 운영 수준 애플리케이션을 목표로합니다.ATCA는 구조, 전원 공급, 열 분산, 상호 연결 및 시스템 관리를 정의하는 핵심 사양을 포함한 일련의 사양으로 구성되어 있습니다.
백플레인 구조의 측면에서 ATCA는 전체 네트워크와 더블 스타와 같은 다양한 토폴로지를 지원합니다.백플레인 전송 프로토콜에서 이더넷, PCIe 및 sRIO를 지원합니다. 최신 버전은 100gbase-kr4 애플리케이션을 지원합니다. 즉, 단일 채널의 최대 속도는 25gbps입니다.
ATCA는 또한 각각 10g 및 25g 속도 응용 프로그램에 대응하는 특별한 표준 백플레인 커ATPLUS 및 ADF + +를 정의합니다.
ATCA는 백플레인 전송에서 여러 프로토콜을 지원하며 전기 표준은 해당 프로토콜 요구 사항을 참조할 수 있습니다.이더넷의 10GBASE Kr / 100gbase kr4와 같은 백플레인 애플리케이션의 전송을 위해 ATCA 표준은 다양한 테스트 장치의 사양 요구 사항을 포함하여 엄격한 테스트 표준과 프로세스를 정의합니다.